
应用文集
-
 纳米银膜烧结界面的断裂特性与微观结构演变2026-05-28
纳米银膜烧结界面的断裂特性与微观结构演变2026-05-28 -
 烧结铜膏:引领下一代功率封装新浪潮2026-05-28
烧结铜膏:引领下一代功率封装新浪潮2026-05-28 -
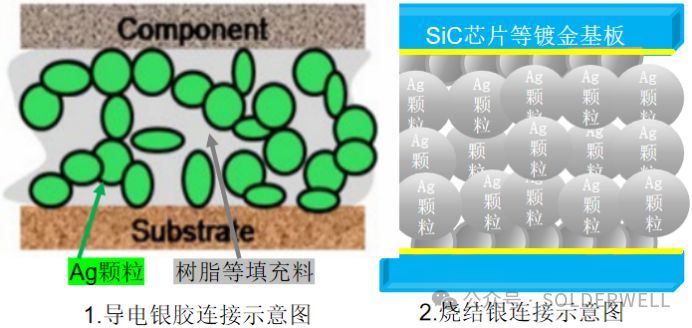 解锁微电子连接的“银”钥匙:为何高端制造离不开烧结银膏?汉源微电子拥有多项烧结银产品发明专利,以领先的工艺能力为功率半导体行业提供高可靠、高性能解决方案。2026-05-19
解锁微电子连接的“银”钥匙:为何高端制造离不开烧结银膏?汉源微电子拥有多项烧结银产品发明专利,以领先的工艺能力为功率半导体行业提供高可靠、高性能解决方案。2026-05-19 -
 大面积烧结剪切强度不足,如何解决?针对大面积(≥40×40mm²)烧结剪切强度不足的问题,广州汉源微电子封装材料有限公司联合天津工业大学研发了一种可实现高剪切强度大面积封装互连的低压烧结银焊膏,通过材料复配的设计与调整提升银焊膏烧结性能。2026-04-02
大面积烧结剪切强度不足,如何解决?针对大面积(≥40×40mm²)烧结剪切强度不足的问题,广州汉源微电子封装材料有限公司联合天津工业大学研发了一种可实现高剪切强度大面积封装互连的低压烧结银焊膏,通过材料复配的设计与调整提升银焊膏烧结性能。2026-04-02 -
 创新工艺|金锡生产效率×尺寸精度双突破广州汉源微电子封装材料有限公司创新推出“高效熔炼+精密成型”工艺体系,在确保金锡合金成分均匀、低氧含量的前提下,大幅提升生产效率与尺寸精度,产品空洞率低于3%,综合性能稳定,可比肩国际品牌。2026-04-02
创新工艺|金锡生产效率×尺寸精度双突破广州汉源微电子封装材料有限公司创新推出“高效熔炼+精密成型”工艺体系,在确保金锡合金成分均匀、低氧含量的前提下,大幅提升生产效率与尺寸精度,产品空洞率低于3%,综合性能稳定,可比肩国际品牌。2026-04-02 -
 金锡共晶焊料@汉源微电子SOLDERWELL广州汉源微电子封装材料有限公司(简称:汉源微电子)金锡共晶焊料(Au80Sn20)以其独特的综合性能,成为光电子封装、大功率器件和高可靠性军用/航空航天电子等领域的理想连接材料。2026-03-11
金锡共晶焊料@汉源微电子SOLDERWELL广州汉源微电子封装材料有限公司(简称:汉源微电子)金锡共晶焊料(Au80Sn20)以其独特的综合性能,成为光电子封装、大功率器件和高可靠性军用/航空航天电子等领域的理想连接材料。2026-03-11








